Второе дыхание 193-нм литографии, или Особенности 32-нм техпроцесса
От диоксида кремния к оксиду гафния
193-нм иммерсионная литография: невозможное возможно
2009-й войдет в историю развития процессоров как год внедрения в массовое производство 32-нм техпроцесса. Напомним, что первая микросхема памяти, созданная по 32-нм техпроцессу, была продемонстрирована компанией Intel еще в 2007 году, а в феврале 2009-го она представила уже рабочую версию процессора, созданного по 32-нм техпроцессу. Поэтому уже сейчас можно утверждать, что ввод в массовое производство 32-нм техпроцесса состоится по плану и в конце этого года мы увидим серийные 32-нм процессоры. Еще пять лет назад считалось, что в основе 32-нм техпроцесса будет лежать так называемая EUV-литография с источником излучения 13,5 нм и что DUV-литографию на основе 193-нм лазера невозможно использовать в 32-нм техпроцессе из-за ограничения в разрешающей способности. Но, как это нередко бывает в физике, невозможное стало возможным! И 32-нм техпроцесс, и следующий за ним 22-нм техпроцесс будут основаны именно на DUV-литографии на базе 193-нм лазера. О том, как такое стало возможным, мы расскажем в этой статье.
От диоксида кремния к оксиду гафния
Начиная с 60-х годов, то есть со времени создания первой микросхемы, и по нынешний день в микросхемах использовались так называемые планарные (плоские) полевые транзисторы с подзатворным диэлектриком на основе диоксида кремния. При этом все усилия электронной промышленности были направлены на то, чтобы уменьшить размеры самого транзистора. Так, в 1965 году в микросхемах интегрировалось всего три десятка транзисторов, а современный процессор Intel насчитывает уже сотни миллионов транзисторов на кристалле. Конечно, в процессе эволюции планарных транзисторов менялись не только их размеры. Существенные изменения претерпели и используемые материалы, и даже геометрия самих транзисторов. Что ж, все логично. Для того чтобы выдержать диктуемые законом Мура экспоненциальные темпы увеличения числа транзисторов в одной микросхеме, необходимо разрабатывать новые технологии производства.
Естественно, уменьшение размеров транзистора сказывается и на других его характеристиках. Так, если считать, что длина затвора транзистора уменьшается в M раз, то во столько же раз уменьшаются и толщина слоя диэлектрика, отделяющего область затвора от кремниевой подложки, и ширина затвора, и рабочее напряжение затвора. Кроме того, в M раз возрастает скорость работы транзистора и квадратично увеличивается плотность размещения транзисторов на кристалле, а рассеиваемая мощность уменьшается в M2 раз.
Таким образом, очевидно, что уменьшение размеров транзисторов положительно сказывается на их характеристиках.
Основная проблема, связанная с уменьшением размеров транзистора, упирается в то, что экспоненциальное увеличение числа транзисторов на кристалле приводит к экспоненциальному росту потребляемой мощности и, как следствие, к перегреву микросхемы. Причин тому несколько, но все они имеют один и тот же корень: уменьшение размеров транзистора приводит к появлению токов утечки. Токи утечки возникают через слой диэлектрика, отделяющего область затвора от кремниевой подложки, а также между истоком и стоком в «выключенном» состоянии транзистора.
Расскажем о причинах возникновения токов утечки в области затвора более подробно. Слой диэлектрика между затвором и кремнием можно рассматривать как плоский конденсатор, емкость которого зависит от диэлектрической проницаемости вещества, толщины слоя диэлектрика и площади затвора по формуле:
![]()
где S — площадь затвора, t — толщина слоя диэлектрика, k — диэлектрическая проницаемость слоя диэлектрика.
Понятие емкости затвора очень важно, так как в том числе и от нее зависит величина тока, проходящего между истоком и стоком. Действительно, поскольку емкость определяет способность накапливать заряд, то при одном и том же напряжении в случае большей емкости можно накопить больший заряд в канале проводимости, а следовательно, и создать больший ток. Таким образом, большая емкость позволяет снижать напряжение на затворе, что немаловажно при уменьшении размеров транзисторов. Кроме того, на ток в канале проводимости оказывает непосредственное влияние и длина самого канала: чем она меньше, тем больший ток можно получить.
По мере уменьшения размеров транзистора уменьшалась и толщина слоя диэлектрика. При этом между длиной канала и толщиной слоя диэлектрика соблюдается простое соотношение: толщина слоя диэлектрика приблизительно в 45 раз меньше длины канала.
Вплоть до настоящего времени в качестве диэлектрического слоя традиционно используется диоксид кремния, диэлектрическая проницаемость которого составляет 3,9. Однако уменьшение толщины слоя диэлектрика, которое приводит к возрастанию емкости затвора, то есть положительно сказывается на характеристиках транзистора, имеет и свои негативные последствия. Дело в том, что при достижении величины в несколько нанометров начинают сказываться эффекты туннелирования зарядов через слой диэлектрика, что приводит к возникновению токов утечки. В частности, в 45-нм техпроцессе производства транзисторов при использовании диоксида кремния в качестве подзатворного диэлектрика его толщина должна была бы составить порядка 1 нм, то есть примерно пять атомарных слоев.
Казалось бы, почему нельзя увеличить толщину диоксида кремния для уменьшения токов утечки? Ответ прост: это привело бы к уменьшению емкости затвора и необходимости увеличения управляющего напряжения, то есть фактически свело бы на нет все преимущества уменьшения размеров транзистора. Поэтому проблему возникновения токов утечки можно решить, только если вместо диоксида кремния использовать другие диэлектрические материалы, позволяющие создавать более толстые слои диэлектрика, но, тем не менее, обеспечивающие неизменную или даже более высокую емкость затворного конденсатора. Такие материалы должны иметь более высокую диэлектрическую проницаемость. Они получили название high-k-диэлектрики.
Пусть, к примеру, емкость конденсатора, образованного диоксидом кремния, равна:
![]()
где kox — диэлектрическая проницаемость диоксида кремния, tox — толщина слоя диоксида кремния.
Емкость конденсатора, образованного high-k-диэлектриком, составляет:
![]()
где khigh-k — диэлектрическая проницаемость high-k-диэлектрика, thigh-k — толщина слоя high-k-диэлектрика.
Для того чтобы емкости затворов с использованием диоксида кремния и high-k диэлектрика были равными, необходимо, чтобы выполнялось условие:
![]()
то есть чтобы толщина слоя high-k-диэлектрика была равна:
![]()
Таким образом, применение альтернативных материалов с более высокой диэлектрической проницаемостью позволяет во столько раз повысить толщину слоя диэлектрика по сравнению с толщиной диоксида кремния, во сколько раз диэлектрическая проницаемость вещества больше диэлектрической проницаемости диоксида кремния. Увеличение же слоя диэлектрика, в свою очередь, позволяет уменьшить токи утечки.
Впервые high-k-диэлектрики начали использоваться в транзисторах при переходе на 45-нм технологический процесс производства, который в этом смысле действительно стал революционным. Так, в 45-нм техпроцессе в качестве подзатворного диэлектрика применяется оксид гафния.
Заменить диоксид кремния на high-k-диэлектрик с целью снижения токов утечки не так просто, как может показаться. И дело в данном случае не в том, что для этого необходимо менять технологический процесс производства микросхем, а в том, что high-k-диэлектрики плохо сочетаются с поликристаллическим кремнием, из которого изготавливается затвор. В научной литературе есть сведения, что использование структуры «high-k/поликремний» приводит к возникновению высокого порогового напряжения в планарных транзисторах. Кроме того, наблюдается значительное снижение активности движения электронов через канал из-за возникновения так называемого поверхностно-оптического фонового режима (SO) и связанного с ним снижения эксплуатационных характеристик транзистора вследствие поляризации high-k-слоя и инверсии заряда материала канала.
В частности, при применении оксида гафния просто невозможно сформировать поликремниевый затвор. Да и с металлическими затворами поверх этого материала все непросто. Поэтому немало сил было потрачено на разработку структуры металлических затворов, которые можно формировать поверх диэлектрика на основе соединений гафния.
Собственно, в разработке такого сочетания high-k-диэлектрика и нового материала затвора и заключался революционный прорыв компании Intel. Сочетание high-k-диэлектрика и нового металлического затвора, в качестве которого используется силицид никеля, позволяет более чем в 10 тыс. раз по сравнению с диоксидом кремния снизить токи утечки, сохранив при этом высочайшие рабочие параметры транзисторов.
Как уже отмечалось, впервые high-k-диэлектрики в сочетании с металлическим затвором из силицида никеля были применены в 45-нм техпроцессе. Использование high-k-диэлектриков предусмотрено и в техпроцессах с проектной нормой 32 и 22 нм. Однако естественно, что в 32-нм техпроцессе речь идет уже о втором поколении high-k-диэлектриков и новом металлическои затворе. Собственно, второе поколение high-k- диэлектриков — этот тот же оксид гафния, но легированный особым образом. Пока Intel не раскрывает, чем именно легирован оксид гафния. В качестве металлического затвора применяется все тот же силицид никеля, но сделанный немного иначе, чем в 45-нм технологии.
193-нм иммерсионная литография: невозможное возможно
Пожалуй, самым невероятным фактом является то, что в 32-нм технологическом процессе производства будет использоваться 193-нм иммерсионная DUV-литография. Еще несколько лет назад никто бы не поверил, что такое вообще возможно. Причем представители компании Intel тоже говорили о необходимости перехода с DUV- на ЕUV-литографию, и казалось, что этот переход просто неизбежен. В разработку новой ЕUV-литографии были в свое время вложены просто колоссальные средства, однако, как это нередко бывает в науке, в последний момент стало понятно, что в самом начале была допущена принципиальная ошибка, которая фактически свела на нет все достижения в области EUV-литографии.
Так, еще в 2004 году компании Intel и Media Lario International S.A. (Италия) сообщили о соглашениях, направленных на разработку ключевых оптических компонентов для EUV-литографии. Тогда ожидалось, что EUV-литография будет внедрена в промышленных масштабах к 2009 году.
В 2005 году сообщалось, что компании Intel и Corning, Inc. заключили соглашение о разработке стеклянных основ фотомасок со сверхнизким распространением тепла ULE (Low Thermal Expansion), необходимых для EUV-литографии. Причем указывалось, что эти фотомаски будут использоваться именно в 32-нм техпроцессе.
Вообще, в свое время EUV-литография была признана консорциумом International Roadmap of Semiconductor Technology самой перспективной технологией литографии следующего поколения, которая будет реализована после нынешнего поколения инструментов литографии с длиной волны 193 нм.
Итак, прежде чем переходить к рассмотрению причин отказа от применения EUV-литографии, давайте вкратце напомним, что такое литография вообще и чем DUV-литография отличается от EUV-литографии.
Как известно, одним из важнейших этапов в производстве микросхем является литографический процесс. Литография — это технология, используемая для нанесения рисунка будущей микросхемы на слой фоторезиста посредством специальных литографических масок.
Важнейшей характеристикой литографического процесса является его разрешающая способность. От нее напрямую зависит минимальная толщина линии, которую можно нанести на фоторезисте. В современном производстве процессоров применяется проекционная литография, обеспечивающая высокое разрешение. В проекционной литографии используются линзы или зеркала, позволяющие проецировать рисунок маски-шаблона с уменьшением масштаба. Разрешающая способность проекционной литографии, то есть минимальная толщина линии, которую можно получить на фоторезисте, определяется критерием Релея:
![]()
где ![]() — длина волны источника излучения, NA — числовая апертура объектива, а k1 — коэффициент пропорциональности, зависящий от типа фоторезиста и самого технологического процесса.
— длина волны источника излучения, NA — числовая апертура объектива, а k1 — коэффициент пропорциональности, зависящий от типа фоторезиста и самого технологического процесса.
Из формулы для разрешающей способности оптической литографии следует, что более высокое разрешение можно получить за счет увеличения числовой апертуры проекционной установки или перехода к источникам излучения с более короткой длиной волны.
Однако увеличение числовой апертуры проекционной установки имеет негативное последствие. Дело в том, что кроме разрешающей способности литографический процесс характеризуется еще и глубиной резкости. Если разрешающая способность определяет характерный поперечный размер фокусировки, то глубина резкости — характерное расстояние фокусировки в продольном направлении. Глубина резкости вычисляется по формуле:
![]()
Как следует из данной формулы, увеличение числовой апертуры объектива негативно сказывается на уменьшении глубины резкости, а чем меньше глубина резкости, тем большую точность необходимо обеспечить при размещении пластины в проекционной установке, чтобы выдержать параллельность ее фокальной плоскости (плоскости фокуса) с точностью до долей микрометра. Поэтому единственный способ увеличить разрешающую способность литографического процесса при заданной глубине резкости заключается в том, чтобы перейти к источниками излучения с более короткой длиной волны.
Если говорить об источниках излучения, то при производстве процессоров в современной литографии используется коротковолновое ультрафиолетовое излучение лазера с длиной волны 193 нм (технологический процесс 180, 130, 90 и 65 нм). Эта литография получила название DUV (Deep UltraViolet — глубокое ультрафиолетовое излучение).
Для того чтобы увеличить разрешающую способность литографического процесса при использовании коротковолнового ультрафиолетового излучения с длиной волны 193 нм, применяют различные технологии улучшения разрешающей способности, например маски-шаблоны с фазовым сдвигом. В таких масках, которые, по сути, представляют собой голограммы, на одну из двух соседних прозрачных линий накладывается фазовый фильтр, сдвигающий фазу проходящей волны на 180°. В результате интерференции волн в противофазе происходит их взаимное ослабление в области между двумя экспонируемыми линиями, что делает их хорошо различимыми и повышает разрешающую способность (см. рисунок).
Шаблоны с фазовым сдвигом начали применять в 65-нм техпроцессе.
В результате предпринятых шагов по улучшению традиционной DUV-литографии выяснилось, что оптическую литографию с источником излучения 193 нм можно использовать и для 45-нм техпроцесса.
Однако при применении коротковолнового ультрафиолетового излучения с длиной волны 193 нм уже недостаточно применять лишь одни маски-шаблоны с фазовым сдвигом, чтобы достичь разрешающей способности, характерной для топологической нормы 32 нм (32-нм техпроцесс).
Именно поэтому считалось, что возможности оптической DUV-литографии ограничены техпроцессом 45 нм и переход на техпроцесс 32 нм потребует использования новых источников излучения. Так, предполагалось, что для литографии с проектной топологией 32 нм будет применяться так называемая ЕUV-литография (Extreme UltraViolet — сверхжесткое ультрафиолетовое излучение), которая основана на использовании ультрафиолетового излучения с длиной волны 13,5 нм.
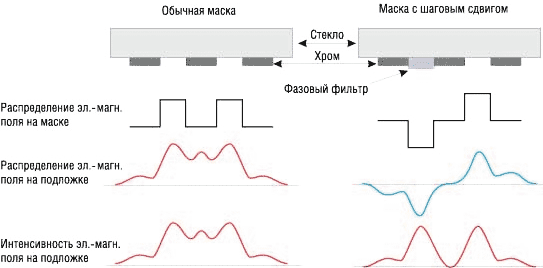
Использование масок с фазовым сдвигом
Разработками в области ЕUV-литографии в компании Intel активно занимались с середины 1990-х годов. В частности, именно компания Intel в 1997 году сыграла решающую роль в формировании консорциума, разработавшего первый инженерный испытательный стенд EUV-литографии, и именно она установила первый в мире коммерческий аппарат EUV Micro Exposure Tool (MET) и пилотную линию по нанесению масок EUV, включающую инструменты восстановления масок и обнаружения дефектов в заготовках масок.
Переход с DUV- на EUV-литографию обеспечивает более чем 10-кратное уменьшение длины волны и переход в диапазон, где свойственные транзисторам размеры сопоставимы с размерами всего нескольких десятков атомов.
Однако с применением ЕUV-излучения связаны и некоторые проблемы. Поскольку свет с длиной волны 13,5 нм поглощается всеми материалами, в том числе стеклом, из которого изготавливаются традиционные линзы, в EUV-литографии используется полностью отражающая, а не пропускающая оптика. Новая технология предполагает применение серии из четырех специальных выпуклых зеркал, которые уменьшают и фокусируют изображение, полученное после использования маски. Каждое такое зеркало содержит 80 отдельных металлических слоев толщиной примерно в 12 атомов.
Маски, которые традиционно являются пропускающими, также должны быть и отражающими. Кроме того, вся система должна находиться в вакууме, поскольку световые волны диапазона EUV поглощаются воздухом.
Успехи в области освоения ЕUV-литографии позволили в лабораторных условиях наносить шаблон с минимальной шириной проводников 27 нм. Однако, как выяснилось, по таким показателям, как производительность, ресурс и воспроизводимость, ЕUV-литография существенно уступает DUV-литографии и пока не может использоваться в массовом производстве микросхем. Фактическая ошибка заключалась в том, что изначально данная технология была ориентирована на газоразрядные лазеры. И только полтора года назад вернулись к разработке плазменных источников излучения, которые позволят преодолеть указанные ограничения EUV-литографии.
Сейчас уже известно, что EUV-литография не будет применяться не только в 32-нм, но и в следующем, 22-нм техпроцессе.
Естественно, возникает вопрос, каким образом DUV-литография с 193-нм источником излучения позволяет получить разрешающую способность, характерную для 32- и 22-нм техпроцессов? Ведь очевидно, что использования одних лишь фазосдвигающих масок в данном случае уже недостаточно. Действительно, применение DUV-литографии в 32- и 22-нм техпроцессах стало возможным лишь благодаря существенным изменениям, позволяющим улучшить разрешающую способность. Так, в 32-нм техпроцессе будет использоваться не «сухая» проекционная DUV-литография, как в 45-нм техпроцессе, а иммерсионная литография. При иммерсионной литографии кремниевые пластины с нанесенным слоем фоторезиста помещаются в воду (жидкость). Идея заключается в том, что коэффициент преломления воды выше, чем коэффициент преломления вакуума, что эквивалентно уменьшению эффективной длины волны проходящего через воду излучения. Причем длина волны уменьшается ровно в n раз, где n — показатель преломления используемой жидкости. Уменьшение длины волны излучения позволяет повысить разрешающую способность литографии.
Пальма первенства в области иммерсионной литографии принадлежит компании IBM. Еще 20 февраля 2006 года она объявила о том, что в лабораторных условиях при применении иммерсионной литографии с источником излучения 193 нм были получены четкие линии шириной всего 29,9 нм, разделенные одинаковыми пробелами. В экспериментах IBM с использованием изготовленной установки, получившей звучное название NEMO, оптика и жидкость имели коэффициент преломления порядка 1,6, а коэффициент преломления фоторезиста составлял 1,7.
Конечно, в иммерсионной литографии есть свои технологические проблемы. Главная из них — это получение жидкости с высоким коэффициентом преломления. При этом жидкость не должна вступать в химическую реакцию с кремниевой подложкой и слоем фоторезиста. Кроме того, при применении иммерсионной литографии приходится учитывать такие негативные явления, как температурные флуктуации жидкости, что приводит к ее неоднородности и, как следствие, к рассеиванию проходящего излучения. Существуют и другие специфические проблемы.
В 32-нм техпроцессе производства в качестве жидкости в иммерсионной литографии будет использоваться вода с коэффициентом преломления 1,4. Для того чтобы обеспечить нужный уровень фильтрации жидкости и освободить ее от микроскопических пузырьков (произвести дегазацию), применяется огромная установка стоимостью примерно 30 млн долл. Проблема взаимодействия жидкости с фоторезистом решается за счет нанесения на слой фоторезиста специального покрытия, препятствующего проникновению образующейся при облучении фоторезиста кислоты в воду.
Как уже отмечалось, в иммерсионной литографии 32-нм техпроцесса используется вода. Однако уже сейчас созданы жидкости с коэффициентом преломления 1,8. Естественно, что применение жидкости с коэффициентом преломления 1,8 требует использования других типов фоторезиста.
Применение иммерсионной 193-нм литографии позволяет достичь разрешающей способности, необходимой в 32-нм техпроцессе. Однако для достижения разрешающей способности, характерной для 22-нм техпроцесса, одной лишь иммерсионной литографии будет недостаточно. Поэтому для повышения разрешающей способности в 22-нм техпроцессе будет применяться иммерсионная 193-нм литография в сочетании с технологией двойной экспозиции. Более того, технология двойной экспозиции будет использоваться и в 32-нм техпроцессе, но только для критически важных узлов.
Идея технологии двойной экспозиции заключается в следующем. Если применяемый литографический процесс не позволяет достичь требуемой разрешающей способности с использованием одной маски, то вместо одной литографической маски можно применять две маски и соответственно два процесса экспозиции фоторезиста. При этом возникает проблема совмещения масок, однако современные степперы обеспечивают совмещение масок с точностью до нанометра.
Фактически двойная экспозиция позволяет повысить разрешающую способность в два раза. Однако она требует вдвое больше и масок, и технологических операций. То есть, попросту говоря, двойная экспозиция получается в два раза дороже, чем одинарная. Но если использовать фоторезист с нелинейными свойствами, то можно сначала сделать двойную экспозицию, а потом уже приступать к этапам проявления и травления.
Таким образом, применение технологии двойной экспозиции позволяет повысить разрешающую способность литографического процесса без необходимости перехода к новым коротковолновым источникам излучения.








