Революция в производстве транзисторов
Устройство традиционного планарного транзистора
Проблемы, возникающие при уменьшении размеров транзисторов
В ноябре 2003 года практически на всех новостных компьютерных сайтах появилась информация о разработке новых, революционных технологий производства транзисторов, которые позволят снизить энергопотребление и тепловыделение в процессорах следующего поколения. Если быть более точным, то речь идет о разработке новых материалов для производства транзисторов. Исследователи корпорации Intel создали транзисторы с рекордно высокими параметрами производительности вследствие использования ранее неизвестного диэлектрика затвора с высокой диэлектрической проницаемостью и новых сплавов для производства затвора транзистора.
 стественно,
такое событие не могло оставить нас равнодушными, и мы решили более подробно
ознакомиться с новаторской технологией производства транзисторов. Но прежде
чем рассказать читателям о деталях этой технологии и углубиться в дебри современной
терминологии, применяемой по отношению к планарным транзисторам, которые используют
при производстве процессоров, нам предстоит сделать небольшое отступление и
рассмотреть принципы функционирования планарных транзисторов.
стественно,
такое событие не могло оставить нас равнодушными, и мы решили более подробно
ознакомиться с новаторской технологией производства транзисторов. Но прежде
чем рассказать читателям о деталях этой технологии и углубиться в дебри современной
терминологии, применяемой по отношению к планарным транзисторам, которые используют
при производстве процессоров, нам предстоит сделать небольшое отступление и
рассмотреть принципы функционирования планарных транзисторов.
Устройство традиционного планарного транзистора
 общем смысле транзистор — это устройство, выполняющее функции электронного ключа.
Транзистор может находиться в одном из двух состояний: включено (транзистор
открыт) или выключено (транзистор закрыт). В этом смысле транзистор подобен
механическому выключателю электрической цепи, однако, в отличие от механического
переключателя, транзистор, во-первых, можно сделать микроскопически малым и
таким образом создавать интегральные микросхемы, насчитывающие сотни миллионов
таких транзисторов, а во-вторых, транзистор представляет собой практически безынерционный
переключатель, который способен работать на частотах, измеряемых терагерцами,
то есть он может включать и выключать цепь триллионы раз в секунду.
общем смысле транзистор — это устройство, выполняющее функции электронного ключа.
Транзистор может находиться в одном из двух состояний: включено (транзистор
открыт) или выключено (транзистор закрыт). В этом смысле транзистор подобен
механическому выключателю электрической цепи, однако, в отличие от механического
переключателя, транзистор, во-первых, можно сделать микроскопически малым и
таким образом создавать интегральные микросхемы, насчитывающие сотни миллионов
таких транзисторов, а во-вторых, транзистор представляет собой практически безынерционный
переключатель, который способен работать на частотах, измеряемых терагерцами,
то есть он может включать и выключать цепь триллионы раз в секунду.
Начиная с 60-х годов, со времени создания первой микросхемы, и по сегодняшний день в микросхемах использовались так называемые планарные полевые транзисторы. Основой этих транзисторов является кремний (Si). Чистый кремний — полупроводник, то есть вещество, по проводимости превосходящее диэлектрики, но уступающее металлам. Кремний в чистом виде (именуемый собственным полупроводником) плохо проводит электрический ток, но проводимость кремния увеличивается по мере роста температуры. В отличие от металлов, где носителями заряда являются свободные электроны, в чистых полупроводниках эту роль играют электроны и дырки. Дырка — это вакантное место для электрона, которое образуется в результате того, что один из валентных электронов разрывает связь со своим атомом и переходит в зону проводимости (то есть становится свободным). Образующийся в результате этого положительный ион представляет собой вакантное место для электрона (место, которое может быть заполнено электроном) и называется дыркой. Дырки и электроны обладают подвижностью и способны проводить электрический ток, причем в чистых полупроводниках концентрация дырок и электронов всегда совпадает друг с другом, а направление движения дырок всегда противоположно движению электронов. Процесс образования дырки и электрона происходит под воздействием тепловой энергии: когда тепловая энергия электрона сравнивается с энергией перехода (с шириной запрещенной зоны), происходит образование одной пары носителей. Очевидно, что с ростом температуры количество дырок и электронов увеличивается и проводимость полупроводника возрастает.
Проводимость полупроводника может быть радикально изменена при помощи примесей. Примесью называется вещество, валентность которого отлична от валентности основного полупроводника. Атомы примеси замещают в кристаллической решетке атомы основного полупроводника (в нашем случае — кремния), в результате чего образуются свободные дырки или электроны. Существует два типа примеси: донорная и акцепторная. Донорная примесь приводит к образованию полупроводников n-типа c электронным типом проводимости, а акцепторная примесь — к образованию полупроводников p-типа с дырочным типом проводимости.
Для создания планарного транзистора в кристаллическом кремнии за счет внедрения примесей формируются две легированные области: сток и исток с электронной (транзистор NMOS-типа) или дырочной (транзистор PMOS-типа) проводимостью. Исток и сток полностью равноправны и идентичны друг другу. В этом смысле транзистор симметричен, то есть сток и исток можно менять местами. Исток — это часть транзистора, откуда истекает ток, а сток — куда ток втекает.
В обычном состоянии электроны (для n-типа) или дырки (для p-типа) хотя и диффундируют в область кремния вследствие избыточной концентрации, но не способны перемещаться между стоком и истоком, поскольку неизбежны процессы рекомбинации в области кремния. Кроме того, за счет такой диффузии на границах контактов между легированными областями стока и истока и кремния возникают локальные электрические поля, препятствующие дальнейшей диффузии и приводящие к образованию обедненного носителями слоя. Поэтому в обычном состоянии прохождение тока между истоком и стоком невозможно. Для того чтобы создать канал переноса заряда между стоком и истоком, используется третий управляющий электрод, называемый затвором (рис. 1) и представляющий собой область в верхней части транзистора, состояние которой определяет, включен транзистор или выключен. Традиционно затвор изготавливается из поликристаллического кремния, в котором атомы кремния расположены случайным образом, а не так, как в пространственной решетке.
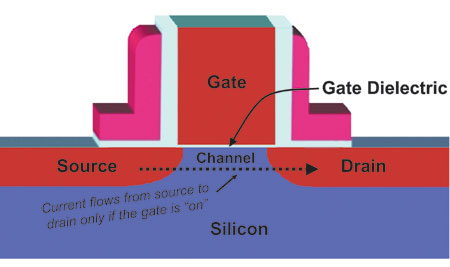
Рис. 1. Схема традиционного планарного транзистора
Затвор отделен от кремниевой подложки слоем диэлектрика (диэлектриком затвора), в качестве которого выступает диоксид кремния (SiO2). Это вещество — хороший изолятор, то есть не является проводником электрического тока. Наличие тонкого слоя диоксида необходимо для обеспечения высоких эксплуатационных характеристик диэлектрика затвора.
При подаче потенциала на затвор создаваемое им электрическое поле вытесняет в глубину кремниевой подложки основные носители заряда кремния, а в образующуюся обедненную носителями область втягиваются основные носители заряда стока и истока (мы говорим об основных носителях заряда, а не о конкретно дырках или электронах, поскольку возможно и то и другое). В результате между истоком и стоком в подзатворной области образуется своеобразный канал, насыщенный основными носителями заряда. Если теперь между истоком и стоком приложить напряжение, то по каналу пойдет ток. В этом случае принято говорить, что транзистор находится в открытом состоянии. При исчезновении потенциала на затворе канал разрушается и ток не проходит, то есть транзистор запирается. NMOS-транзисторы включаются, когда на затвор подается положительный потенциал, а PMOS-транзистор — при отрицательном напряжении.
Проблемы, возникающие при уменьшении размеров транзисторов
 ся
история развития электронной промышленности начиная с 1959 года, когда была
создана первая интегральная микросхема, развивалась по пути уменьшения размеров
транзисторов и увеличения плотности их размещения на кристалле. Так, самые первые
интегральные микросхемы содержали всего несколько десятков микросхем, а современный
процессор Intel Pentium 4 насчитывает уже 55 млн. транзисторов на кристалле.
Считается, что плотность размещения транзисторов на кристалле подчиняется так
называемому закону Мура, согласно которому количество транзисторов в одной микросхеме
удваивается каждые 18 месяцев. Это закон (а точнее, предсказание) был сформулирован
Гордоном Муром (Gordon E. Moore) еще в 1965 году, когда по просьбе журнала Electronics
он написал статью, в которой был дан прогноз относительно того, как будут совершенствоваться
полупроводниковые устройства в течение ближайших десяти лет. Проанализировав
темпы развития полупроводниковых устройств и экономические факторы за прошедшие
шесть лет, то есть с 1959 года, Мур предположил, что к 1975 году количество
транзисторов в одной интегральной микросхеме составит 65 тыс., то есть за десять
лет оно увеличится более чем в 1000 раз. А это означало, что каждый год количество
транзисторов в одной микросхеме должно удваиваться.
ся
история развития электронной промышленности начиная с 1959 года, когда была
создана первая интегральная микросхема, развивалась по пути уменьшения размеров
транзисторов и увеличения плотности их размещения на кристалле. Так, самые первые
интегральные микросхемы содержали всего несколько десятков микросхем, а современный
процессор Intel Pentium 4 насчитывает уже 55 млн. транзисторов на кристалле.
Считается, что плотность размещения транзисторов на кристалле подчиняется так
называемому закону Мура, согласно которому количество транзисторов в одной микросхеме
удваивается каждые 18 месяцев. Это закон (а точнее, предсказание) был сформулирован
Гордоном Муром (Gordon E. Moore) еще в 1965 году, когда по просьбе журнала Electronics
он написал статью, в которой был дан прогноз относительно того, как будут совершенствоваться
полупроводниковые устройства в течение ближайших десяти лет. Проанализировав
темпы развития полупроводниковых устройств и экономические факторы за прошедшие
шесть лет, то есть с 1959 года, Мур предположил, что к 1975 году количество
транзисторов в одной интегральной микросхеме составит 65 тыс., то есть за десять
лет оно увеличится более чем в 1000 раз. А это означало, что каждый год количество
транзисторов в одной микросхеме должно удваиваться.
Конечно, в те времена ни сам Гордон Мур, ни кто-либо другой не мог предположить, что опубликованный прогноз на ближайшие десять лет не только в точности сбудется, но и послужит основой для формулирования эмпирического правила развития всей полупроводниковой технологии на много лет вперед. Впрочем, с предсказанием Мура было не все гладко. К 1975 году рост количества элементов в одной микросхеме стал немного отставать от прогноза, и тогда Мур скорректировал период обновления до 24 месяцев, чтобы компенсировать ожидаемое увеличение сложности полупроводниковых компонентов (рис. 2).

Рис. 2. Рост числа транзисторов в процессорах компании Intel
Закон Мура, появившийся как эмпирическое правило, за десятилетия своего существования превратился в один из основных принципов развития полупроводниковой индустрии. С той же неизменностью, с которой зима сменяет осень, а лето — весну, все более мощное и высокоинтегрированное поколение микросхем с постоянной периодичностью приходит на смену предыдущему поколению. При этом уверенность скептиков и маловеров в скорой «кончине» закона Мура парадоксальным образом только усиливается — хотя с внедрением данного поколения Intel справилась, но разработка следующего сопряжена с еще более возросшими в силу физических законов трудностями, и уж тут-то Intel наверняка забуксует! Между тем вся история Intel доказывает, что скептики ошибаются...
Конечно, в процессе эволюции планарных транзисторов менялись не только их размеры. Существенные изменения претерпели и используемые материалы, и даже геометрия самих транзисторов, поскольку для того, чтобы выдержать экспоненциальные темпы увеличения числа транзисторов в одной микросхеме, диктуемые законом Мура, необходимо разрабатывать новые технологии производства. Обратившись к ближайшим планам корпорации Intel по выпуску процессоров (табл. 1), можно сделать вывод, что если сейчас в производство внедряется 90-нанометровый технологический процесс производства микросхем, при котором длина затвора транзистора составляет 50 нм, то в 2009 году планируется освоить промышленный выпуск транзисторов с длиной затвора уже 15 нм (32-нанометровый технологический процесс). Всего же за последние пять лет длина затвора транзистора уменьшилась в четыре раза (табл. 1).
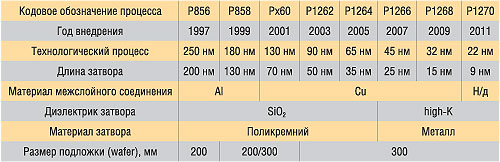
Таблица 1. Темпы сокращения длины затвора транзистора
Естественно, уменьшение размеров транзистора сказывается и на других его характеристиках. Так, если считать, что длина затвора транзистора уменьшается в M раз, то в такое же количество раз уменьшается и толщина слоя диэлектрика, отделяющего область затвора от кремниевой подложки, и ширина затвора, и рабочее напряжение затвора. Кроме того, в M раз возрастает скорость работы транзистора, квадратично увеличивается плотность размещения транзисторов на кристалле, а рассеиваемая мощность уменьшается в M2 раз (табл. 2). Таким образом, становится очевидно, что уменьшение размеров транзисторов положительно сказывается на их характеристиках.

Таблица 2. Изменение характеристик транзистора при уменьшении его геометрических размеров
Сегодня, когда размер транзисторов от поколения к поколению неуклонно уменьшается, а плотность их интеграции на кристалле стремительно возрастает, разработчикам становится все труднее решать технологические проблемы, возникающие в силу действия естественных законов физики.
Главными барьерами на пути миниатюризации транзисторов являются выделение тепла при работе транзистора и утечка электрического тока в том же процессе. Чем меньше транзистор, тем выше тепловыделение и тем больше ток утечки. Токи утечки возникают через слой диэлектрика, отделяющего область затвора от кремниевой подложки, и между истоком и стоком при выключенном состоянии транзистора. Причина возникновения тока утечки через слой диэлектрика заключена в толщине этого слоя. Дело в том, что по мере уменьшения размеров транзистора становилась меньше и толщина слоя диэлектрика (рис. 3).

Рис. 3. Тенденция сокращения толщины диоксида кремния в транзисторах
При этом между длиной канала и толщиной слоя диэлектрика соблюдается простое соотношение:
 ,
,
то есть толщина слоя диэлектрика приблизительно в 45 раз меньше длины канала. Таким образом, в процессе изготовления транзисторов по 90-нанометровой технологии корпорации Intel толщина этого слоя составляет 1,2 нм, или всего 5 атомов. При столь малой толщине слоя диэлектрика начинают проявляться квантовые эффекты туннелирования, приводящие к возникновению паразитных токов утечки.
Прежде всего, попробуем разобраться с вопросом, почему толщина слоя диэлектрика является настолько значимой величиной и как это отражается на скоростных и прочих характеристиках транзистора. Слой диэлектрика между затвором и кремнием можно рассматривать как плоский конденсатор, емкость которого зависит от диэлектрической проницаемости вещества, толщины слоя диэлектрика и площади затвора и определяется по формуле:
 ,
,
где S — площадь затвора, d — толщина слоя диэлектрика, e — диэлектрическая проницаемость слоя диэлектрика.
В этом смысле понятие емкости затвора очень важно, так как емкостью определяется в том числе и величина тока, проходящего между истоком и стоком. Действительно, поскольку емкость определяет способность накапливать заряд (Q = CU), то при одном и том же управляющем напряжении на затворе при большей емкости можно накопить больший заряд в канале проводимости, а следовательно, создать больший ток. В связи с этим большая емкость позволяет снижать напряжение на затворе, что немаловажно при уменьшении размеров транзисторов. Кроме того, на ток в канале проводимости непосредственно влияет длина самого канала: чем она меньше, тем больший ток можно создать. В общем случае можно сказать, что величина тока между истоком и стоком определяется по формуле:
 ,
,
где m — подвижность носителей заряда, W и L — ширина и длина канала проводимости, U — управляющее напряжение затвора, Un — напряжение срабатывания, C — емкость подзатворной области.
Таким образом, увеличивая емкость подзатворной области за счет уменьшения толщины слоя диэлектрика, можно уменьшать управляющее напряжение на транзисторе (а значит, и сокращать энергопотребление), оставлять при этом неизменным силу тока между истоком и стоком.
Как уже говорилось, в качестве диэлектрического слоя традиционно используется диоксид кремния, диэлектрическая проницаемость которого составляет 3,9. Последние 15 лет производители полупроводников активно стремятся уменьшать размеры слоя диоксида кремния, снижая энергопотребление и повышая эксплуатационные характеристики микросхем.
Однако уменьшение толщины слоя диэлектрика, которое приводит к возрастанию емкости затвора (то есть положительно сказывается на характеристиках транзистора), имеет негативные последствия, связанные с эффектами туннелирования зарядов через слой диэлектрика, что приводит к возникновению токов утечки.
При производстве процессоров по 90-нанометровому технологическому процессу толщина слоя диоксида кремния составляет всего 1,2 нм, а в лабораторных условиях были продемонстрированы результаты экспериментальных исследований эксплуатационных характеристик транзисторов, в которых использовался слой диоксида кремния величиной 0,8 нм (длина затвора 15 нм). Данные исследований показывают, что каналы транзисторов с 0,8-нм толщиной слоя диоксида кремния обладают хорошей управляемостью. Фактически это уже близко к пределу для данного материала, поскольку в результате дальнейшего уменьшения самого транзистора и, как следствие, утоньшения слоя диоксида кремния ток утечки через диэлектрик затвора заметно возрастет, что приведет к значительным потерям тока и к избыточному тепловыделению. По оценкам экспертов корпорации Intel, в современных чипах уже почти 40% энергии теряется из-за утечек.
«В области полупроводникового производства долгие годы считалось, что тепловыделение и токи утечки являются основной преградой для дальнейшего развития индустрии в соответствии с законом Мура и с использованием сегодняшних транзисторных материалов и структур, — заявил Сунлинь Чжоу (Sunlin Chou), старший вице-президент корпорации Intel и генеральный менеджер подразделения Technology and Manufacturing Group. — Перед отраслью давно стоит глобальная задача разработки и внедрения новых материалов взамен диоксида кремния, находящегося на пределе своих возможностей. Решение этой задачи по степени важности иногда сравнивают с созданием искусственного сердца».
High-K-диэлектрики
 ля
решения этой важнейшей проблемы корпорация Intel планирует заменить используемый
в настоящее время диоксид кремния слоем диэлектрика с высокой диэлектрической
проницаемостью, что позволит значительно снизить токи утечки. Применение таких
материалов диэлектрической проницаемости позволяет использовать более толстые
слои диэлектрика (а значит, снизить токи утечки) при обеспечении требуемого
значения емкости подзатворного конденсатора.
ля
решения этой важнейшей проблемы корпорация Intel планирует заменить используемый
в настоящее время диоксид кремния слоем диэлектрика с высокой диэлектрической
проницаемостью, что позволит значительно снизить токи утечки. Применение таких
материалов диэлектрической проницаемости позволяет использовать более толстые
слои диэлектрика (а значит, снизить токи утечки) при обеспечении требуемого
значения емкости подзатворного конденсатора.
Такие вещества получили название high-K-диэлектрики (буква K также обозначает диэлектрическую проницаемость).
Буква «K» (греческая буква «каппа») в данном случае указывает на способность материала сохранять электрический заряд. Для того чтобы лучше понять этот процесс, проведем аналогию: губка может впитать много воды; дерево тоже может впитать некоторое количество воды, но не так много; стекло же вообще не может впитывать воду. Подобно этому некоторые материалы могут хранить электрический заряд лучше, чем другие, то есть обладают высокой величиной «K». Применение материалов на основе технологии high-K значительно уменьшает утечки, поскольку эти материалы могут иметь большую толщину, чем диоксид кремния, при сохранении тех же свойств.
Пусть, к примеру, емкость конденсатора, образованного диоксидом кремния, равна:
 ,
,
где kox — диэлектрическая проницаемость диоксида кремния, dox — толщина слоя диоксида кремния. Аналогично емкость конденсатора, образованного диэлектриком с высоким значением k, составляет:
 ,
,
где khigh-K — диэлектрическая проницаемость high-K-диэлектрика, dhigh-K — толщина слоя диэлектрика high-K.
Емкость затвора с диэлектриком из оксида кремния будет равна емкости затвора с high-K-диэлектриком при выполнении условия:
 ,
,
Из полученного равенства следует, что для обеспечения равной емкости эквивалентная толщина high-K-диэлектрика (Equivalent Oxide Thickness, EOT) должна быть равной:
 ,
,
Таким образом, использование альтернативных материалов с более высокой диэлектрической проницаемостью позволяет во столько раз повысить толщину слоя диэлектрика по сравнению с толщиной диоксида кремния, во сколько раз диэлектрическая проницаемость вещества больше диэлектрической проницаемости диоксида кремния (рис. 4). А увеличение слоя диэлектрика, в свою очередь, позволяет уменьшить токи утечки.
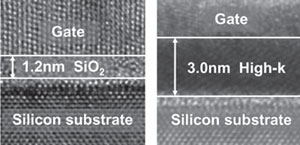
Рис. 4. Увеличение толщины слоя диэлектрика при переходе к high-K-материалам
Для замены диоксида кремния, то есть в качестве high-K-материалов, рассматривались различные варианты, в частности Y2O3 , La2O3 , ZrO2 , HfO2 , Ta2O5 и др. Так, согласно информации компании Intel, большинство high-K-диэлектриков изготовлены на основе гафния и циркония. К примеру, диоксид циркония ZrO2 обладает диэлектрической проницаемостью равной 25, что в 6,4 раза больше, чем диэлектрическая проницаемость диоксида кремния. Следовательно, для обеспечения той же самой подзатворной емкости при применении диоксида циркония можно использовать в шесть с лишним раз более толстый слой диэлектрика, а это позволяет снизить ток утечки примерно в 10 тыс. раз.
Для получения диоксида циркония сначала на поверхность кремния осаждают хлористый цирконий ZrCl4 , после чего под воздействием пара он превращается в диоксид циркония, а побочный продукт реакции (соляная кислота) испаряется (рис. 5):
Заменить диоксид кремния на high-K-диэлектрики с целью снижения токов утечки не так просто, как может показаться. И дело в данном случае не в том, что придется менять технологический процесс производства микросхем, а в том, что high-K-диэлектрики плохо сочетаются с поликристаллическим кремнием, из которого изготавливается затвор. В научной литературе есть сведения, что использование структуры «high-K/поликремний» приводит к возникновению высокого порогового напряжения в планарных транзисторах. Кроме того, наблюдается значительное снижение активности движения электронов через канал из-за возникновения так называемого поверхностно-оптического фонового режима (SO) и связанного с ним снижения эксплуатационных характеристик транзистора вследствие поляризации high-K-слоя и инверсии заряда материала канала.

Рис. 5. Получение диоксида циркония или гафния
Поэтому второй важнейшей проблемой является поиск нового материала для самого затвора, который может заменить поликремний и хорошо сочетается с high-K-диэлектриками. Собственно, в разработке такого сочетания high-K-диэлектрика и нового материала затвора и заключается революционный прорыв компании Intel. Естественно, о подробностях этого открытия не сообщается, то есть не предан гласности ни материал high-K-диэлектрика, ни материал, из которого изготавливается затвор. Известно только, что речь идет о сочетании диэлектрика со сплавом металла.
По сведениям корпорации Intel, сочетание диэлектрика затвора с высокой диэлектрической проницаемостью и нового сплава для изготовления затвора позволяет более чем в 100 раз по сравнению с диоксидом кремния снизить токи утечки, сохранив при этом высочайшие рабочие параметры транзисторов. На данный момент в лабораторных условиях созданы высокоэффективные PMOS- и NMOS-транзисторы со стеками, полученными по технологии «high-K/металл». Эти транзисторы обладают длиной затвора равной 80 нм и толщиной слоя оксида приблизительно 1,4 нм. Отмечается, что транзисторы обоих типов показывают очень высокую эффективность при установке соответствующего порогового напряжения и имеют хорошую управляемость характеристик канала.
Специалисты корпорации Intel убеждены, что новые материалы, созданные в результате многолетних исследований, можно интегрировать в экономически эффективный массовый производственный процесс. Транзисторы, изготовленные на основе таких материалов и обладающие рекордными параметрами производительности, рассматриваются в качестве базового варианта для будущих процессоров Intel в рамках производственного процесса с проектной нормой 45 нм (техпроцесс под кодовым номером 1266), который будет запущен в массовое производство уже в 2007 году.
Технологические новации корпорации Intel произвели в компьютерном сообществе эффект разорвавшейся бомбы. «Диоксид кремния в течение многих лет был сердцем транзистора, и его замена сравнима по значимости с операцией по пересадке сердца», — считает Робин Дегрейв (Robin Degraeve), исследователь из бельгийского межуниверситетского центра микроэлектроники, продолжая медицинскую аналогию Сунлиня Чжоу. Таким образом, последовательно инвестируя значительные средства в научные исследования и новые разработки, корпорации Intel удается опровергнуть скепсис оппонентов в плане выполнения закона Мура, продолжая создавать все более мощные и в то же время компактные устройства для самого широкого круга пользователей.
Говоря о перспективах производства процессоров с проектной нормой 45 нм, следует отметить, что сочетание high-K-диэлектриков с металлическим материалом затвора — не единственное нововведение. В частности, в транзисторах следующего поколения будет использоваться технология напряженного, или растянутого, кремния (Strained Silicon Technology) — (рис. 6), которую корпорация Intel планирует использовать уже при производстве микросхем с проектной нормой 90 нм. Идея указанной технологии предельно проста. Как уже было сказано, при миниатюризации транзисторов и уменьшении площади их сечения возрастает сопротивление электрическому току, который проходит через транзистор. В результате транзистор «срабатывает» гораздо медленнее, чем хотелось бы, а тепловыделение, наоборот, только увеличивается. Специалисты корпорации Intel решили «растянуть» кристаллическую решетку в транзисторе, чтобы увеличить расстояние между атомами и облегчить протекание тока.
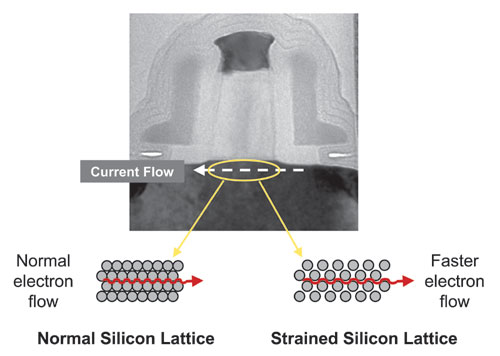
Рис. 6. Эффект напряженного кремния
Известно, что создание напряжений в пространственной решетке — таких, чтобы атомы кремния находились друг от друга на расстоянии чуть большем, чем их естественное расстояние, — приводит к ускорению переключений транзисторов типа NMOS (так же, как сжатие пространственной решетки приводит к аналогичному эффекту для транзисторов типа PMOS). Это «растяжение/сжатие» именуют напряжением. Инженеры подразделения Logic Technology Development Division корпорации Intel разработали два различных способа для NMOS- и PMOS-транзисторов. В NMOS-транзисторах поверх транзистора в направлении движения электрического тока наносится слой нитрида кремния (Si3N4), вследствие чего кремниевая кристаллическая решетка «растягивается». В PMOS-устройствах это достигается за счет нанесения слоя SiGe в зоне образования переносчиков тока — здесь решетка «сжимается» в направлении движения электрического тока, а потому «дырочный» ток течет свободнее. В обоих случаях прохождение тока значительно облегчается: в первом случае — на 10%, во втором — на 25%, а соединение обеих технологий дает 20-30%-ное ускорение тока.
Другим направлением исследования являются так называемые трехмерные tri-gate-транзисторы c тройным затвором, о разработке которых было объявлено в сентябре 2002 года. Такие транзисторы рассматриваются в качестве основы для 45-нанометрового технологического процесса 2007 года. Вышеописанные транзисторы были планарными, то есть имели один плоский затвор, параллельный поверхности кремниевой подложки. В транзисторе на основе технологии tri-gate использована новая трехмерная структура, в которой затворы как бы «обернуты» вокруг трех сторон кремниевого канала (рис. 7).
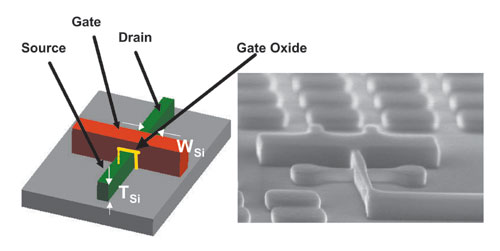
Рис. 7. Структура транзистора с тройным затвором
Данная структура позволяет посылать электрические сигналы как по «крыше» транзистора, так и по обеим его «стенам». Благодаря подобной схеме распределения тока эффективно увеличивается площадь, доступная для прохождения тока, а значит, снижается его плотность, а вместе с ней уменьшается и утечка. Особенностью этой конструкции также являются поднятые исток и сток — в результате снижается сопротивление, что позволяет транзистору работать при токе меньшей мощности.
Важно отметить, что транзисторы на основе технологий high-K/metal gate и tri-gate не противоречат, а, скорее, дополняют друг друга. Поэтому транзистор будущего поколения, вероятно, будет воплощать в себе обе технологии.
При написании статьи использованы материалы, предоставленные компанией Intel








